Cleaning Equipment

-
FOUP Cleaner
반도체 제조용 Wafer를 담는 용기를 세정하는 장비로 FOUP(Front Open Unified Pod)에 들어있는 이물질을 제거하는 것이 목적인 장비.
Process Application : 300mm Foup Cleaning (Shinetsu, Entegris, etc, All Foup application), Only empty FOUP supply
The Merits : Small Footprint, High throughput, N2 Purge & Close system
Features
- Spin RPM : Max. 200 RPM
- Nozzle : High pressure spray
- DHF, DI Cleaning
- Hot DI Cleaning Hot N2 Blowing, N2 Purge & Close system
- Robot : X-Y-Z-R Axis Robot, Auto Tilting, High Power, Fast Speed

-
In-situ FOUP Cleaner
Process Application : 300mm FOUP Cleaning (Shinetsu, Entergrise, etc, All FOUP application), None empty FOUP supply
The Merits : Vacuum Out Gassing, FOUP Inspection, OHT Handling Minimize
System Performance
- Spin RPM : Max. 400 RPM
- Nozzle : High pressure spray
- Hot DI Cleaning & Hot CDA Drying
- 2 Vacuum Dryer
- Humidity Check & Particle Check (Optional)
- 6 or 7 FOUP Sticker
- Wafer Dumper
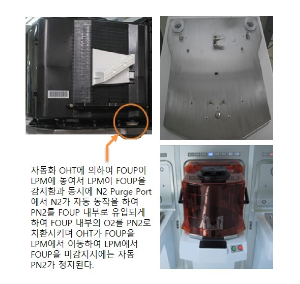
-
NPK (Nitrogen Purge Kit)
- FOUP 내부 Auto N2 Purge 가능
- FOUP 내부의 O2 제거로 Natural Oxide 성장억제 효과 탁월 (Run 대기 타임 증대로 수율 및 생산성 향상)
- 간단한 개조로 개조비용 최소화
- 기타 설비의 LPM에 NPK를 간단히 적용 가능 (호환성 우수)
- FDC Data 자동화 소프트웨어 가능
- Gate Oxide 공정 후 산화막 성장방지
- Poly Deposition 공정전 산화막 성장방지
- Etch Back 후 Barrier Metal 공정 진행전 산화막 성장방지

-
Spin Cleaner
Process Application : Spin Develop, Etcher, Strip, DI Rinse, Spin Dryer
The Merits : Small Footprint & Low COO(Reduction Chemical and DI)
System Performance
- FOUP 내부 Auto N2 Purge 가능
- FOUP 내부의 O2 제거로 Natural Oxide 성장억제 효과 탁월 (Run 대기 타임 증대로 수율 및 생산성 향상)
- 간단한 개조로 개조비용 최소화
- 기타 설비의 LPM에 NPK를 간단히 적용 가능 (호환성 우수)
- FDC Data 자동화 소프트웨어 가능
- Gate Oxide 공정 후 산화막 성장방지
- Poly Deposition 공정전 산화막 성장방지
- Etch Back 후 Barrier Metal 공정 진행전 산화막 성장방지
